01 - 미래에 대해 이야기하기
다음 내용은 주로 첨단 반도체 기술에 대한 최고의 컨퍼런스인 IEEE IEDM(International Electron Devices Meeting)에서 발췌한 것입니다.극도의 데이터 추구로 인해 인공 지능은 반도체 로드맵에 새로운 요구 사항을 제시하고 있습니다.
기존의 2D 스케일링이 느려짐에 따라 3D 아키텍처의 혁신은 장치에서 시스템 레벨에 이르기까지 여러 벡터에 걸쳐 가속화됩니다. 아마도 가장 큰 영향은 이기종 통합을 통해 볼륨 확장을 위한 완전히 새로운 기회를 창출하는 고급 패키징일 것입니다.
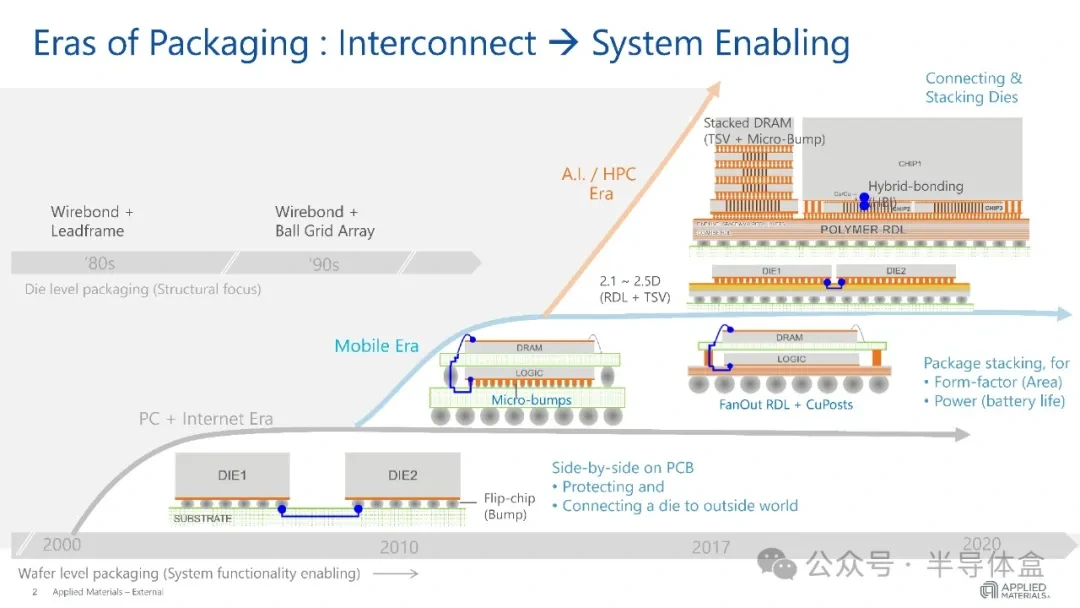
그림 1: 패키징 방법의 진화(From:AMAT)
핵심 내용: 최초의 3D 패키징 시스템이 시장에 출시된 지금, 업계는 어떻게 "3D를 넘어서" AI의 진정한 잠재력을 실현할 수 있을까요? 토론에서 몇 가지 주요 주제가 나왔는데, 패널들은 "3D는 여기에 있으며, 지금은 무엇인가?"에 대해 논의했습니다. ":
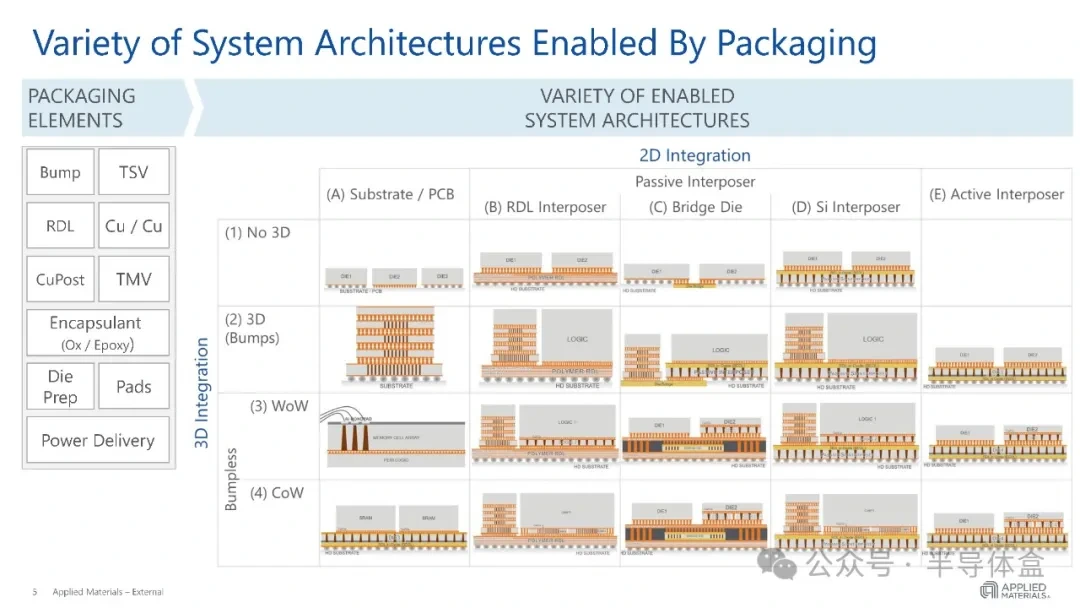
그림 2 package 메서드에 구현된 다양한 구조체(From:AMAT)
패널 사회자인 이안 커트리스(Ian Cutress)는 무어의 법칙(Moore's Law)의 변화하는 성격에 대해 논의했습니다. 오랫동안 트랜지스터 밀도와 경제성의 징후로 여겨졌지만, 인공 지능 시대에는 이제 가능한 한 많은 트랜지스터를 단일 패키지 시스템에 넣는 것을 중심으로 합니다. "2030년까지 1조 개의 트랜지스터를 개발하겠다는 포부에 대해 이야기하는 기업들이 있는데, 이는 첨단 패키징과 3D 기술에 의해 가능해졌습니다."AMD의 디팍 쿨카르니(Deepak Kulkarni)는 패키징 혁신을 위한 세 가지 핵심 방향인 3D 다층 스태킹, 2.5D 패키징, 공동 패키징 광학 장치를 강조했다.
"이 모든 분야에서 에너지 효율성이 크게 개선되었습니다"라고 그는 말했습니다. "우리는 캡슐화를 위해 컴퓨팅과 메모리를 래핑하고 싶지 않습니다. 우리는 이러한 모든 구성 요소를 가능한 한 서로 가깝게 만들어 에너지 효율성을 높이고자 합니다. 에너지 효율성은 3D 기술 다음으로 큰 원동력입니다. "
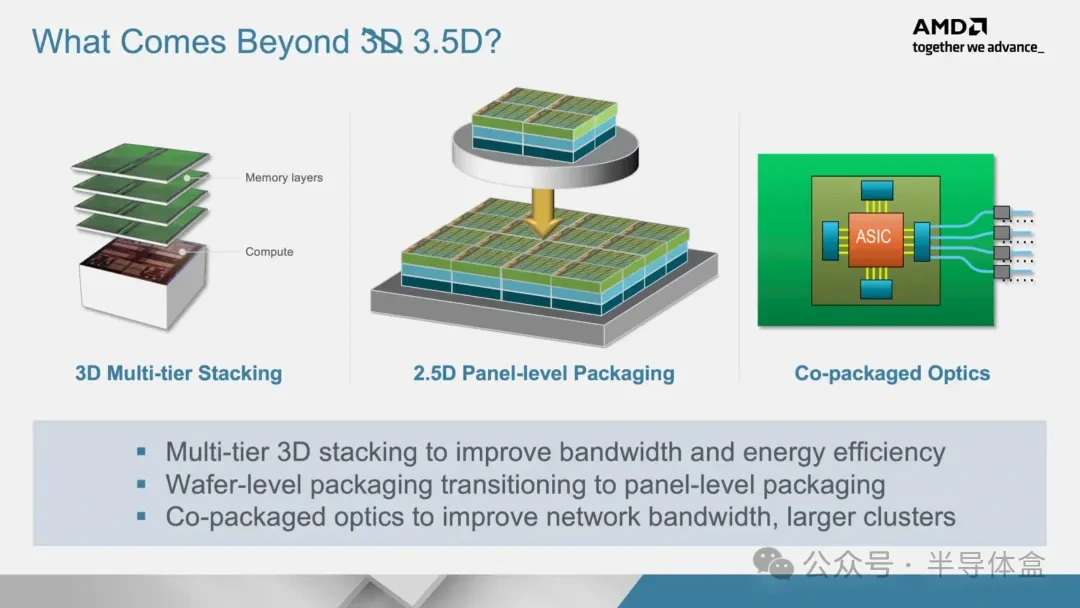
그림 3 패키징 혁신의 세 가지 핵심 방향(출처:AMAT).
인텔의 요한나 스완(Johanna Swan)은 AI의 전력 수요를 관리하기 위해 하이브리드 본딩을 통한 인터커넥트 확장의 중요성을 강조했습니다. "하이브리드 본딩은 현재 일부 제품에서 특정 규모에 도달했습니다 – 약간 적습니다"라고 그녀는 말합니다10 미크론 – 그러나 나는 그것이 계속 1 미만이 될 것이라고 생각합니다. 미크론. "에너지를 줄이는 데 필요한 밀도를 높이는 데 정말 도움이 됩니다. "
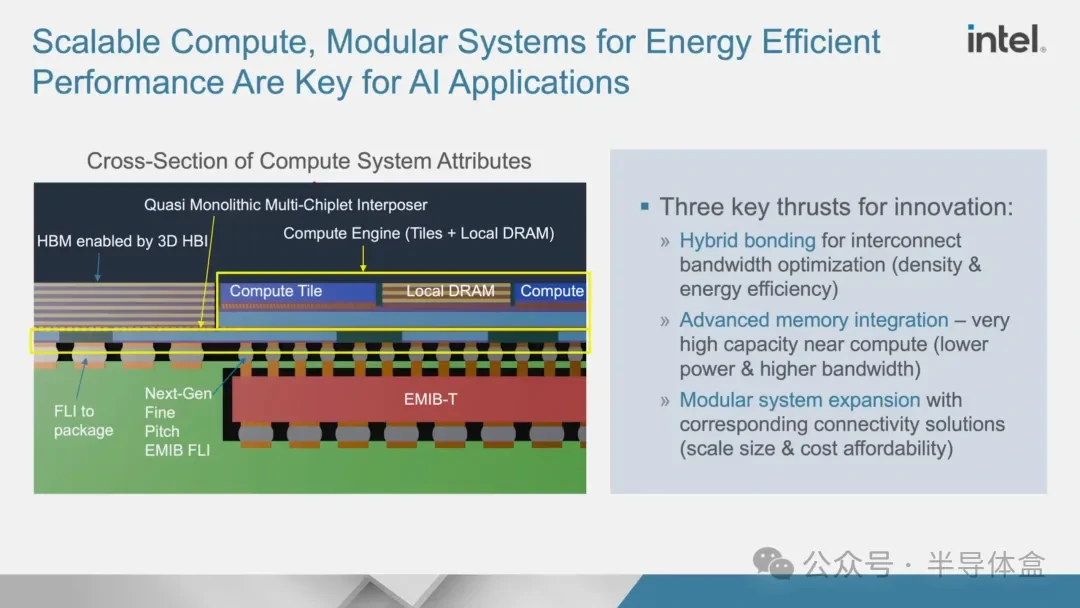
그림 4: 칩의 에너지 효율 성능의 핵심 요소 (출처: AMAT).
Cadence 의 Kam Kittrell은 다음과 같이 설명합니다. 설계 기술과 신소재를 통한 열 관리에 대한 수요가 증가하고 있습니다. "2D 칩을 작업할 때 열 방출이 마지막 단계입니다." 그가 말했다. "이제 칩을 쌓아서 하나의 패키지에 모두 넣을 때마다 열을 배출하기가 매우 어렵고 열로 인해 통제할 수 없는 열 효과가 발생합니다. 열이 위로 올라가고 위에 있는 칩이 다른 칩보다 뜨거워지기 때문에 이러한 칩을 너무 높게 쌓는 것은 매우 어렵습니다. "

Fig.5 Al의 촉진 효과 (From:AMAT)
어플라이드 머티어리얼즈(Applied Materials)의 테리 리(Terry Lee)는 로드맵을 가속화하고 새로운 기술을 더 빠른 속도로 대량 생산에 도입하기 위해 에코시스템 전반에 걸친 협업의 필요성에 대해 논의합니다. "하이브리드 본딩과 같은 것을 볼 때, 우리는 실제로 프론트 엔드 툴링 기능을 포장 공간에 도입하려고 노력하고 있습니다"라고 그는 말했습니다. "아이디어는 하나의 환경에 다양한 칩을 배치하여 생산성을 높이고 대기 시간과 결함을 줄이며 하나의 시스템에 넣어 고객의 수율과 생산성을 높이는 방법입니다."
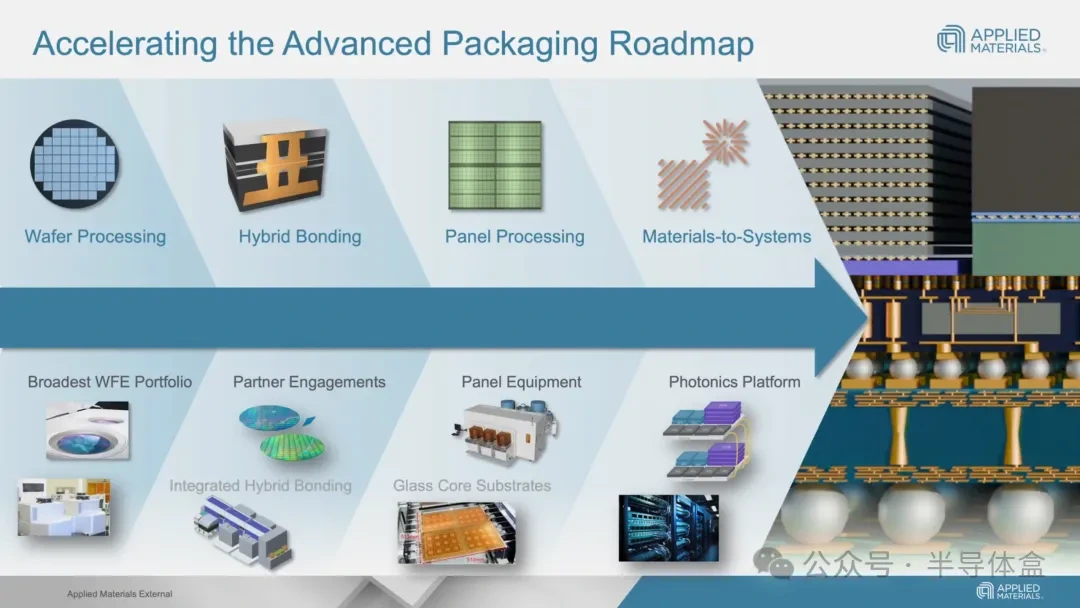
그림 6: 고급 패키징 로드맵 개발 가속화(From:AMAT)위의 내용은 Advanced Packaging Enters a New Dimension- AMAT 블로그에서 발췌한 것입니다.
02 - 상호 연결 체계 레이아웃
AMAT는 고급 패키징의 인터커넥트를 위한 전체 프로세스 솔루션을 보유하고 있습니다. 올해 매우 인기 있는 HBM을 예로 들면, HBM의 밀도와 대역폭은 고급 패키징을 통해 달성됩니다. HBM의 제조 공정은 기존 DRAM을 제조하는 데 필요한 약 700개의 공정 단계에 약 19개의 재료 엔지니어링 단계를 추가하며, 이 중 약 75%는 MAT 적용 장비에서 제공됩니다.

HBM DRAM의 핵심 구성 요소는 적층된 칩을 전기적으로 연결하는 데 사용되는 수직 와이어인 TSV(through-silicon vias)입니다. AMAT는 TSV 개발의 선구자입니다. 약 15년 전, AMAT는 업계 최초의 TSV 프로세스 및 통합 개념을 개발하기 위해 유럽 연구 기관인 IMEC의 핵심 파트너가 되었습니다. 이 협력을 통해 HBM에서 현재 TSV 표준이 만들어졌습니다.
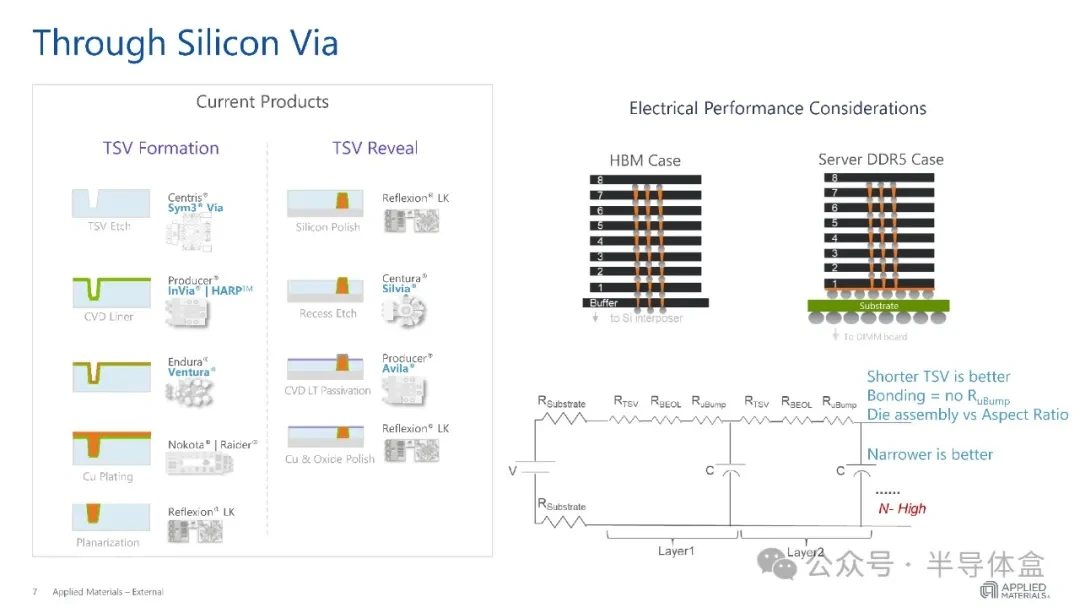
그 이후로 AMAT는 TSV 및 기타 HBM 패키징 단계를 위한 몇 가지 고유한 추가 솔루션을 개발했습니다. 이러한 기술은 칩 인터커넥트 케이블링에 대한 AMAT의 심층적인 기능을 활용하며, 여러 프런트 엔드 웨이퍼 처리 장비 기술을 활용하여 HBM 스택을 구축하는 데 필요한 백엔드 패키징 단계를 향상시킵니다. 업계 최고의 첨단 포장 가공 장비 공급업체인 AMAT는 HBM에서 선도적인 위치를 차지하고 있습니다. 그 결과, AMAT는 HBM 패키징 매출이 2024 회계연도에 6배 증가하여 6억 달러 이상에 이를 것으로 예상하고 있다.
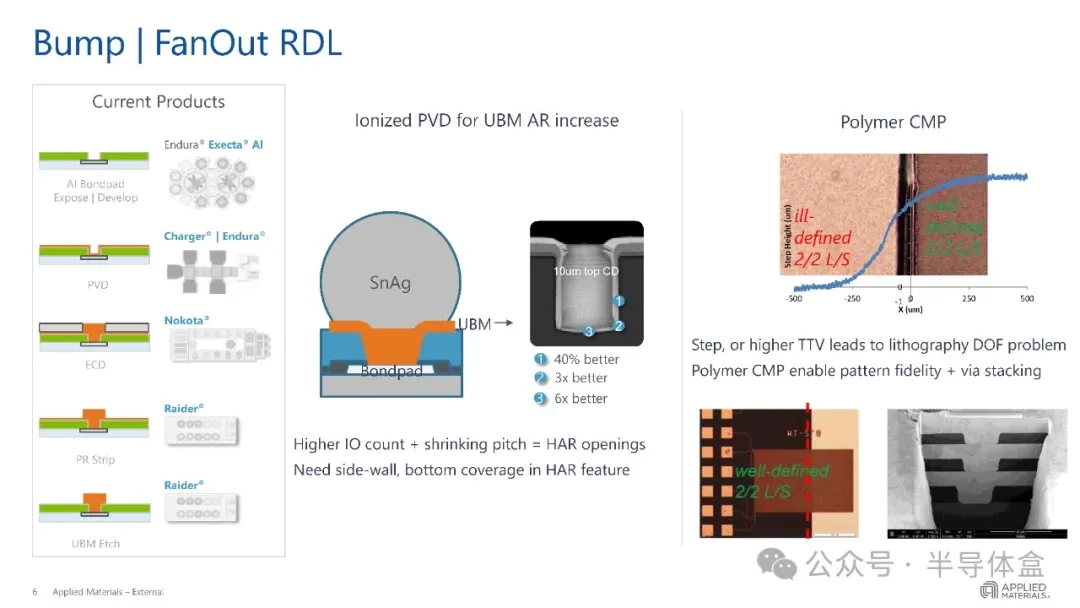
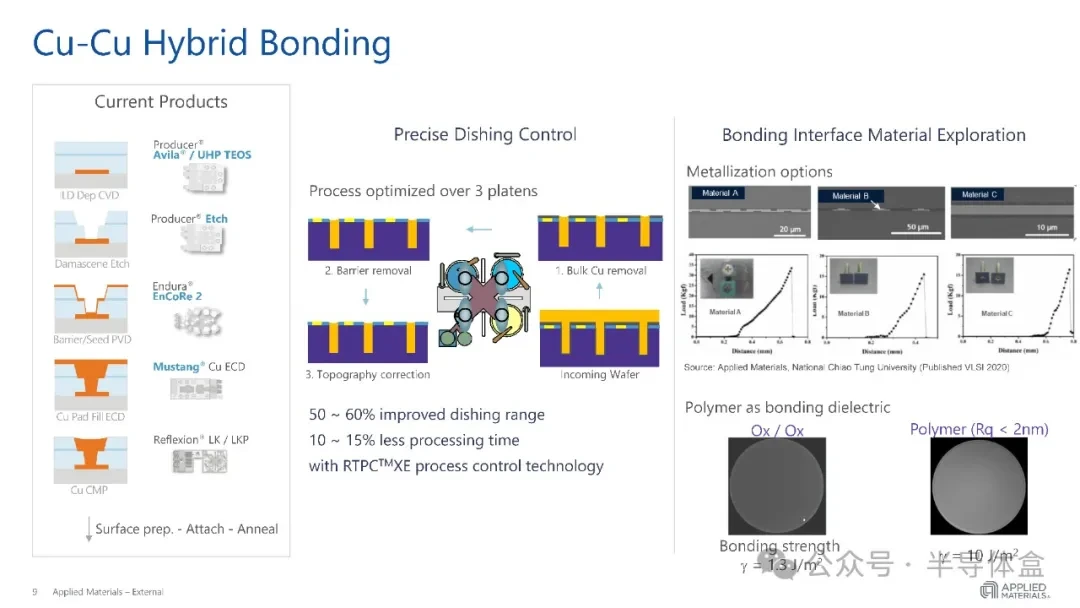
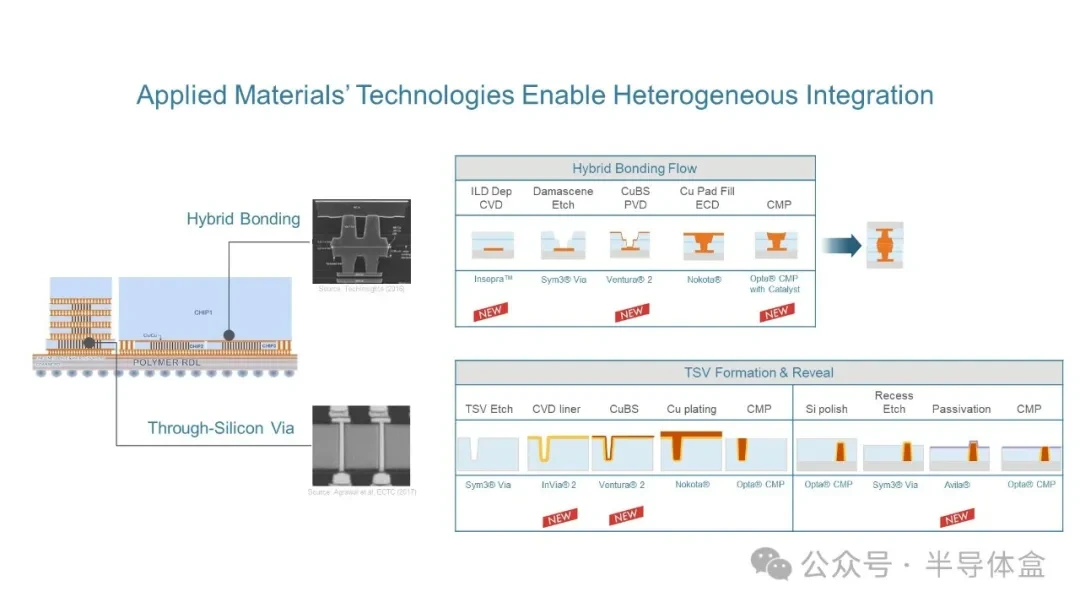
'Semiconductor' 카테고리의 다른 글
| AMEC - 0.2 옹스트롬 (Å) 에칭 정확도 돌파구 달성 !!! (0) | 2025.04.04 |
|---|---|
| 중국 대세 반도체 회사 - SiCARRIER (New Kailai - 新凯来) !!! (1) | 2025.04.03 |
| SEMICON China 2025 - Shang hai (0) | 2025.03.28 |
| 에칭(ETCH) 장비 및 장비 제조업체 たち !!! (0) | 2025.03.28 |
| SEMICON CHINA - WUXI 2025 참가업체 목록 맵 (반도체 패키징 및 테스트) (0) | 2025.03.25 |





댓글